聚焦离子束fib的应用(聚焦离子束系统有哪些特点)
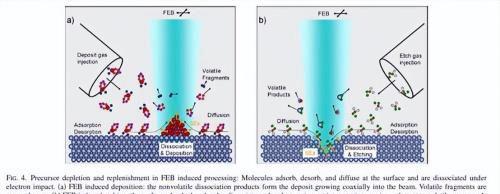
导语:聚焦离子束(FIB)系统中如何注入气体?
在聚焦离子束系统中通常会根据需要配有某些类型的气体,这些气体大致可以分为两类。如下图所示,一类是用于离子束诱导沉积,通常称此类气体为诱导气体;另一类气体则可以提高离子束的溅射速率,称为反应气体。
下面分别对这两类气体进行简单介绍。
离子束诱导沉积
可以通过离子束诱导沉积的金属材料有金、钨、铂、铝等,非金属材料 有硅、二氧化硅等。实现沉积的方法是通过一个针头状的细管使相应的诱导气体流向材料表面欲沉积的部位,此时诱导气体通常以单分子层的形式吸附在材料表面,在入射离子束的轰击下使得吸附的气体分子分解,最终将金属材料留在固体表面,需要指出的是入社的离子束对于新沉积的材料也是有溅 射作用的,也就是说净沉积速率=沉积速率—溅射速率,因此在诱导沉积时离子束能量必须降低来减小溅射速率,当沉积速率高于溅射速率时,就可以产生沉积,当有源源不断的诱导气体补充时则沉积可以保持。
本实验室配有碳和铂两种沉积气体,下面以铂为例介绍一下具体操作方法,首先在调整好共心高度后。
定位好要沉积的点
2. 锁住样品台
3. 进针:右侧工具栏:Pt—heat;→Pt
4. 画 pattern,选择 PtDep
5. 加热完成,弹出窗口
6. 可以用 beam shift 移动样品位置。在 Ibeam 中调焦、调象散,以保证形状精度
7. 电子束:辅助沉积:用 F7 选择小区域加速 Pt 沉积;实时观测:用 live模式实时观测,但电子束的电流需大于离子束的电流
8. 退针:Pt→右键关掉 heater 气体沉积在使用中有哪些常见问题呢?
1.有些时候气体沉积表现为刻蚀,由什么原因造成?
影响气体沉积表现的原因为到达样品表面的气体的量以及离子束能量的大小,所以可能的原因有:
1)离子束束流过大导致溅射速率大于沉积速率;
2)喷射出来的气体的量过小,即气体快要用完或是流出速率设置过小;
3)样品表面离气体出口较远导致到达样品表面气体量过小,即样品表面低于共心高度;
4)在样品目标位置和气体出口之间有有遮挡导致气体无法到 达。
2. 什时候选用铂什么时候选用碳?
如果是仅用于保护截面可以用 C,尤其是对于要减到很薄的 TEM 样品,C 可以减小离子束减薄过程中产生的“门帘效应”。
如果要做电极或者需要一定的连接强度则选用铂沉积。
3. 束流的选择有什么原则?
从图中可以看出束流过大或过小沉积效率都比较低,下面给出集中常见诱导气体的参考束流:铂:2-6pA/μm2,钨:70-100 pA/μm2,碳:1-10 pA/ μm2。
离子束辅助气体刻蚀
在聚焦离子束刻蚀的区域通入某些反应气体可以大大提高离子溅射率产额,一部分是反应气体是通过改变靶材表面的束缚能,或者直接与靶材表面起化学反应,从而提高产额,但是大多数的反应气体注入是减少了溅射材料的再沉积从而提高产额的。
值得注意的是一种反应气体对不同材料的刻蚀速率的增强因子是不同的,因此人们通常利用选择性对不同材料进行选择性刻蚀。
例如:XeF2 做反应气体对绝缘材料比对金属有更高的刻蚀速率,因此用于集 成电路的刻蚀,可以使金属结构暴露出来,以便对电路进行分析。
本文内容由小媛整理编辑!