底部填充胶使用常见问题及芯片用胶方案有哪些(底部填充胶工艺技术)
导语:底部填充胶使用常见问题及芯片用胶方案
随着手机、电脑等便携式电子产品的发展趋向薄型化、小型化、高性能化,IC封装也趋向小型化、高聚集化方向发展。BGA(球栅阵列)封装、CSP(芯片级封装)、Flip chip(倒装芯片)封装、QFP(方型扁平式封装)得到快速应用,封装工艺要求越来越高,底部填充胶的作用也越来越凸显,但是也会遇到一些使用问题,施奈仕便和大家分享下底部填充胶使用常见问题及芯片用胶方案。
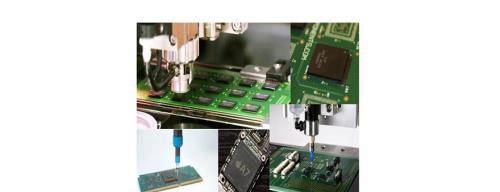
常见问题:
一、胶水渗透不到芯片底部空隙
这种情况属胶水粘度问题,也可以说是选型问题,胶水渗透不进底部空隙,只有重新选择合适的产品,施奈仕底部填充胶,流动性好,在毛细作用下,对BGA封装模式的芯片进行底部填充,再利用加热的固化形式,快达3-5分钟完全固化,将BGA底部空隙大面积填满(填充饱满度达到95%以上),形成一致和无缺陷的底部填充层,并且适合高速喷胶、全自动化批量生产,帮助客户提高生产效率,大幅缩减成本。

二、胶水不完全固化或不固化
助焊剂残留会盖住焊点的裂缝,导致产品失效的原因检查不出来,这时要先清洗残留的助焊剂。但是芯片焊接后,不能保证助焊剂被彻底清除。底部填充胶中的成分可能与助焊剂残留物反应,可能发生胶水延迟固化或不固化的情况。要解决由助焊剂影响底部填充胶能否固化的问题,首先要防止助焊剂的残留,以及要了解胶水与助焊剂的兼容性知识,施奈仕底部填充胶具有工艺简单、优异的助焊剂兼容性、毛细流动性、高可靠性边角补强粘合等特点,并且施奈仕可以全方位提供用胶方案,有效解决此问题。

芯片用胶方案
一、BGA和CSP是通过锡球固定在线路板上,存在热应力、机械应力等应力集中现象,如果受到冲击、弯折等外力作用,焊接部位容易发生断裂。此外,如果上锡太多以至于锡爬到元件本体,可能导致引脚不能承受热应力和机械应力的影响。因此芯片耐机械冲击和热冲击性比较差,出现产品易碎、质量不过关等问题。
推荐方案:
使用底部填充胶,芯片在跌落测试和高低温测试中有优异的表现,所以在焊球直径小、细间距焊点的BGA、CSP芯片组装中,都要使用sirnice底部填充胶进行底部补强。sirnice底部填充胶的应用,可以分散降低焊球上的应力,抗形变、耐弯曲,耐高低温-50~125℃,减少芯片与基材CTE(热膨胀系数)的差别,能有效降低由于硅芯片与基板之间的总体温度膨胀特性不匹配或外力造成的冲击。底部填充胶受热固化后,可提高芯片连接后的机械结构强度

二、对于航空航天和军工产品,引脚脚跟处锡的上方水平线低于引脚脚尖处锡的上方水平线;引脚脚尖的下边未插入锡中;焊盘相对引脚的位置不对,引脚脚跟处没有上锡。上述结构都可能会导致PCBA间歇性不良
推荐方案:
底部填充胶主要用于CSP、BGA 等倒装芯片的补强,提高电子产品的机械性能和可靠性。为了满足可靠性要求,倒装芯片一般采用施奈仕底部填充技术,对芯片和线路板之间的空隙进行底部填充补强。使用施奈仕底部填充胶,可以增强BGA封装模式芯片和PCBA间的抗跌落性能,提高产品的可靠性。
免责声明:本站部份内容由优秀作者和原创用户编辑投稿,本站仅提供存储服务,不拥有所有权,不承担法律责任。若涉嫌侵权/违法的,请反馈,一经查实立刻删除内容。本文内容由快快网络小海创作整理编辑!